レーザーリフロー式チップ搭載装置 LAPLACE特長・メリット
Laser加熱によるChip実装方法には様々な特徴・メリットがございます。
Laser 工程 vs. Thermal工程
- 高速リフロー
- Thernal bondingやリフローオーブンと比べて短時間が可能
- 短時間Pulseによりハンダ接合時に熱ストレス最小化可能
- Chip/部品の片面浮きを回避可能
25umピッチの無電解微細UBMを用いた接続抵抗測定 *高温放置(150℃@1000hr)での接続抵抗推移
ハンダ溶融工程比較
| - 表面実装/ Reflow | 230 - 250 C | 60 - 180 sec (minutes) |
| - Thermal 工程 | 250 - 300 C | 1 - 10 sec (seconds) |
| - Laser 工程 | 250 - 600 C | 0.01-0.2 sec (milliseconds) |
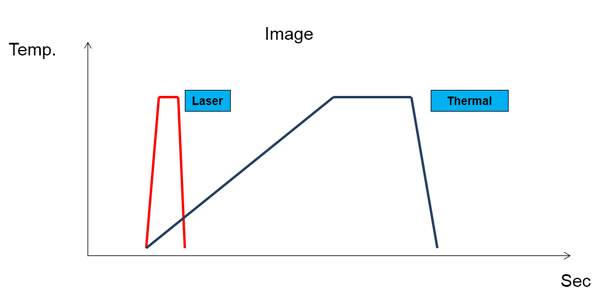
LAPLACE Laserの面内熱均一性
通常のレーザー
均一化されたレーザー
精度の高い温度管理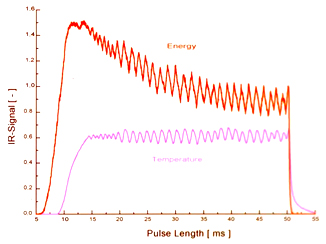
| 項目 | 仕様 |
|---|---|
| レーザー | 9xx nm |
| 対応チップサイズ | サイズ:0.5 - 20mm、厚さ:80-760μm ※20mm以上は要相談 |
| 対応基板サイズ | 50×50mm-300×300mm |
| ボンドツール | セラミック製(個別設計) |
| ボンディングフォース | 30kg max |
| XY軸駆動 | Gantry System (Linear motor system) |
| 搭載精度 | ±20μm(X,Y,Z) ±10μm ,5μm,2.5μm (オプション) |
| 搭載時間 | 5 sec/chip、UPH720 (±3μm精度時) 1 sec/chip、UPH3600 (±20μm精度時) |
最少の熱ストレス
Laserにより部分的に加熱をするため、デバイス全体に熱ストレスをかけることなく実装が可能です。
高いスループット
LaserはThermal Compressionと比べて昇温・降温が速いため、高いスループットを実現可能です。
高い位置制御
部分的な加熱により、デバイスの膨張が無く、高い位置精度で実装が可能です。
ビーム形状と均一化

- PacTechは光学ビーム変調技術を20年以上開発し続けています
- "Force Alighnment”により高い精度に位置決め
- Laserビーム形状をフレキシブルに変更可能
- 最大20x20mm²の照射が可能 ※ 20x20mm²以上は要相談
Laplace技術の優位性
- Laserにより局所加熱可能
- ボンディングエリア外はいっさい加熱無
- 基板や接合部において低ストレス
- Laserによる短時間加熱が過剰加熱を防ぐ
- 膨張による反りが発生しない
- 基板全体の加熱が無い
- 熱に敏感な基板や線膨張係数差の大きい基板の実装が可能
- 高い実装精度
- 様々な基板への実装が可能 (FR4、エポキシ、ポリイミド、セラミックス など)
- 様々な金属膜への実装が可能 (Cu、NiAu、Sn、Au、NiAu など)