レーザーリフロー式チップ搭載装置 LAPLACE原理
レーザー実装技術
Laser式標準Flip Chipプロセス
- Laserリフロー時ChipはVacuumと荷重により固定
- "Force Alighnment"により高い精度に位置決め
- toolサイズはChipサイズと同じサイズ
- Laserリフロー時に高さ(Z方向)を調整

非接触式標準Flip Chipプロセス(コンタクトレス)
- ハンダ上にChipを搭載、tool上昇
- "Self Alignment"により位置調整
- サイズバラツキに対して高い許容性

Laserリフロー式垂直Flip Chip実装
- 連続Laserリフローを利用し、Vacuumと荷重によりChipをハンダ上に搭載
- 高い実装精度実現
- Laserリフロー方向は可変
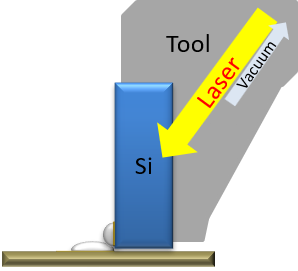
Repair プロセス
- VacuumによりChipを固定
- Laserリフロー時に荷重
- "Optical window"を通じて下面からLaserを照射
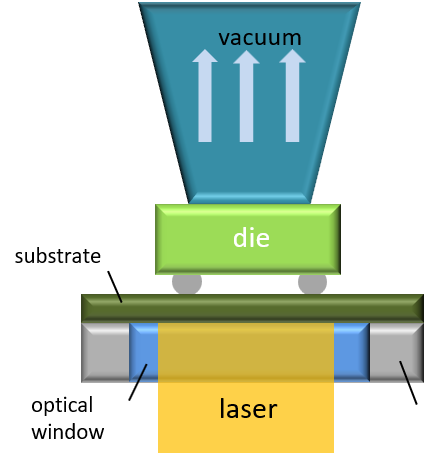
Flip Chipファイバー接合
- Support/transfer film上にChipを搭載
- 光学エネルギーを伝送するFiber Laser搭載Bond toolを使用
- 基板上のChipに荷重を加えるために凸型Laser fiberを使用

Laser Reflowプロセス
Laserプロセスイメージ
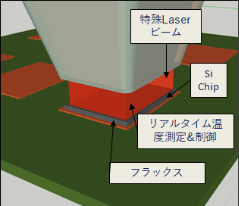
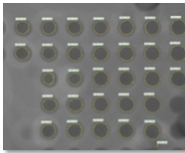

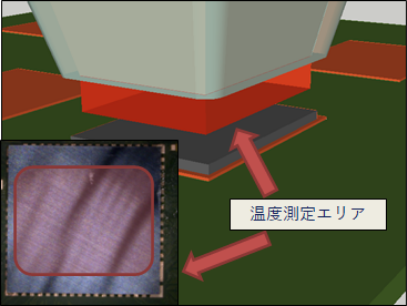
Laser実装技術
LAB:Laser Assist BondingとTCB:Thermo Compression Bonding比較
- 発熱体がBond toolを加熱
- Bond toolが熱エネルギーを実装エリアの基板に伝導
- Bond tool経由で接触式センサーが熱測定&制御
- Bond toolの加熱による熱膨張が追加キャリブレーションを必要とする
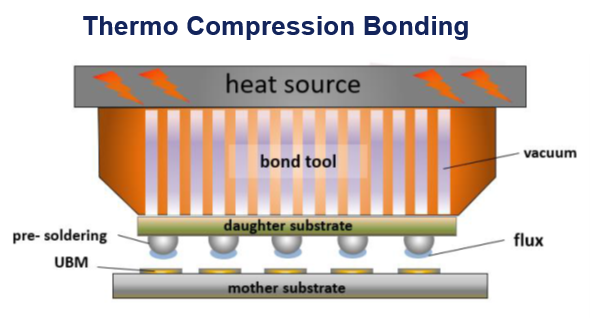
- 変調Laserビームが実装エリアのみを光学的に加熱
- 基板表面の温度を非接触で測定
- セルフアライメントによりコンタクトレスリフロープロセスも可能