LAPLACE-Can
プローブカード組み立てを対象としたMEMSカンチレバー実装のためのレーザーアシストボンダー。
詳細はこちら(PacTech社サイト)
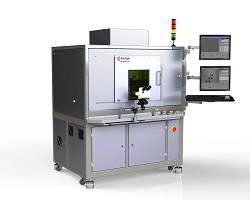
用途やニーズに合わせて、多種多様な装置をご用意しています。
プローブカード組み立てを対象としたMEMSカンチレバー実装のためのレーザーアシストボンダー。
詳細はこちら(PacTech社サイト)
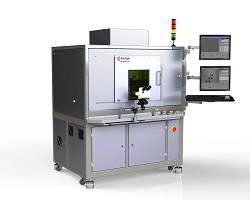
基板に対しチップを立てた状態での垂直実装が可能なレーザーアシストボンダー。
詳細はこちら(PacTech社サイト)
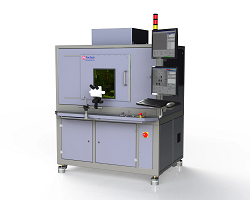
LAPLACE-CanとLAPLACE-VCの比較
| item | LAPLACE-Can | LAPLACE-VC |
|---|---|---|
| サイズ | 1520 x 1100 x 1890 mm | 1520 x 1100 x 1890 mm |
| 可動エリア | Work area: 330 x 330 mm Substrate size: up to 500 x 500 mm |
Work area: 330 x 330 mm Substrate size: up to 500 x 500 mm |
| サイクルタイム | ≥ 7 sec / pin | ≥ 10 sec / chip |
| 実装精度 | Placement: +/- 3.5 μm (3 sigma) Hump tilt: +/- 3 μm Height control: +/- 4 μm |
'+/- 3 μm (1 sigma) |
| ツール | カスタムボンドツール | カスタムボンドツール |
| チップハンドリング | Waffle Pack / Probe Wafer | Waffle Pack / Wafer |
| 基板ハンドリング | マニュアル / オート | マニュアル / オート |
| 製品搬送 | マニュアル / オート | マニュアル / オート |
| Pattern Recognition | ✓ | ✓ |
| 2D用途 | - | - |
| 3D用途 | ✓ | ✓ |
| チップリペア | オプション | - |
| アプリケーション | Probecards, DRAM, flash memory, NAND |
Memory chips, diode (photodiode, LED, μLED), MEMS (sensors,gyroscopes, etc.) |
フリップチップ実装のための統合的なレーザーアシストボンディングシステム。
詳細はこちら(PacTech社サイト)
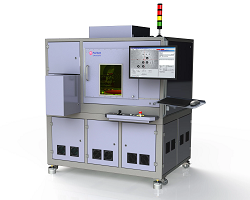
LAPLACE-FCとLAPLACE-GENESISの比較
| item | LAPLACE-FC | LAPLACE-GENESIS |
|---|---|---|
| サイズ | 1500 x 1200 x 2200 mm | |
| 可動エリア | 320 x 320 mm | |
| サイクルタイム | ≥ 5 sec / chip | |
| 実装精度 | +/- 4.5 μm (3 sigma) | '+/- 0,5 μm (3 Sigma) |
| ツール | カスタムツール | |
| チップハンドリング | Waffle Pack、ダイシングフレーム、テープ&リール | |
| 基板ハンドリング | マニュアル / オート | |
| 製品搬送 | マニュアル / オート | |
| Pattern Recognition | ✓ | |
| 2D用途 | ✓ | |
| 3D用途 | - | |
| チップリペア | オプション | |
| アプリケーション | Flip Chip, passive components, sensors, MEMS | |
フリップチップ実装、チップリワークを追加リフローや物理的ストレス無で行う事が可能。
本システムはWaferや基板から検出済みの不良チップを吸着ツールを用いて除去いたします。
新たなチップがWaffle Packなどから取り出され、不良箇所に搭載されます。

ショットキーダイオードやバイパスダイオードなど、太陽電池向けモジュールの組み立てに適したレーザーアシストボンダー。
詳細はこちら(PacTech社サイト)